光致发光成像装置
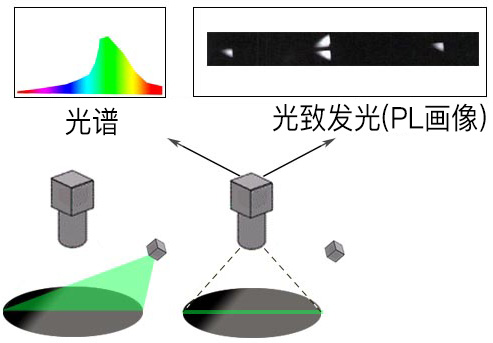
光致发光法(PhotoLuminescence)是一种光谱测量方法,观察光或激光等照射到检查对象上时,检查对象吸收光子(Photon)后再发光现象的手法。
在较高的分辨率下,不仅可以获得光致发光图像(PL图像),还可以获得光谱信息。因此可以确认半导体圆晶的结晶缺陷的位置。从基础型号,到圆晶整个表面的测量以及彩色光致发光图像测量,量产工序专用测量等各种型号可供选择。
特点

◆作为高性能光谱系统取得了许多实绩
◆从研发用标准机到具有波长扫描功能的多功能机的各种机型可供选择
◆可通过表面观察检测缺陷
◆通过组合显微观察像,可以显示整个晶片表面的缺陷分布
◆可以进行颜色测量
◆根据用户需求灵活配置系统
产品阵容
SiC评估用PL成像系统,能够以1μm或更小的分辨率测量光致发光(PL)图像。通过使用在移动样本的同时执行成像测量的平铺功能,可以获得具有大约33亿像素的分辨率的整个6英寸晶片的PL图像。
标准型PLI-210

◆标准型PL成像装置,能够以1μm以下的分辨率获得PL图像
◆使用晶片全面测量的定时功能,则在φ150mm(6英寸)晶片中可以获得分辨率2.6μm、总像素数33亿像素的PL图像
◆从测量层次缺陷的紫外波长范围到测量基面错位缺陷和贯通错位缺陷的红外波长范围均有相应的高效相机
能够采集彩色图像的 PLI-210D

◆搭载了颜色再现性出色的高灵敏度彩色相机,可取得层次缺陷的彩色PL图像
◆通过层次缺陷PL图像的彩色化,实现层次缺陷的结晶结构的区别
◆能够同时测量黑白和彩色图像,通过一次晶片全面测量获取两种PL图像
◆通过键盘操作也能进行高灵敏度黑白相机的层次缺陷测量
光谱线分析型 PLIS-TEC

◆在PL成像图像中选择的线段中,同时测量将线段划分为1000点的各光谱
◆能偶对扩展缺陷进行测量
◆即使对于难以定位的缺陷,例如基面过渡,也可以准确地测量光谱
研究型 PLI-50

◆在保持对PL成像测量非常重要的功能的同时降低成本的模型,例如φ150mm晶圆的整个表面测量的平铺
◆通过添加可选的物镜,也可以实现分辨率为1μm或更小的PL图像测量
高速型PLI-SR
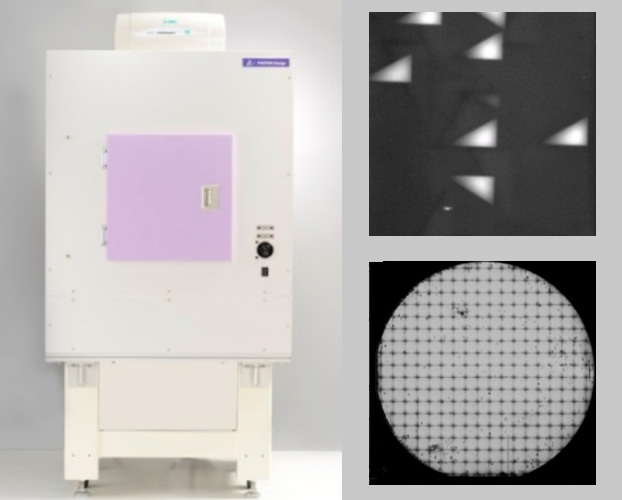
◆通过深景深实现立体形状的检查
◆可对有光泽的金属表面进行检查
◆可检测轮胎表面的低对比度缺陷
◆可对镜子、灯等镜面进行检查
PL光谱成像装置PLIS-200

◆用于SiC半导体的PL成像装置,除了光致发光成像测量外,还可以测量晶体缺陷的光谱
◆通过PL成像功能确认晶体缺陷后,使用PL成像功能将激光的照射位置叠加在晶体缺陷图像上,实现可视化
◆可以精确定位测量点
测量事例

◆聚合型带端PL图像(左)与Deep Level PL图像(右)的比较(1)

◆聚合型带端PL图像(左)与Deep Level PL图像(右)的比较(2)
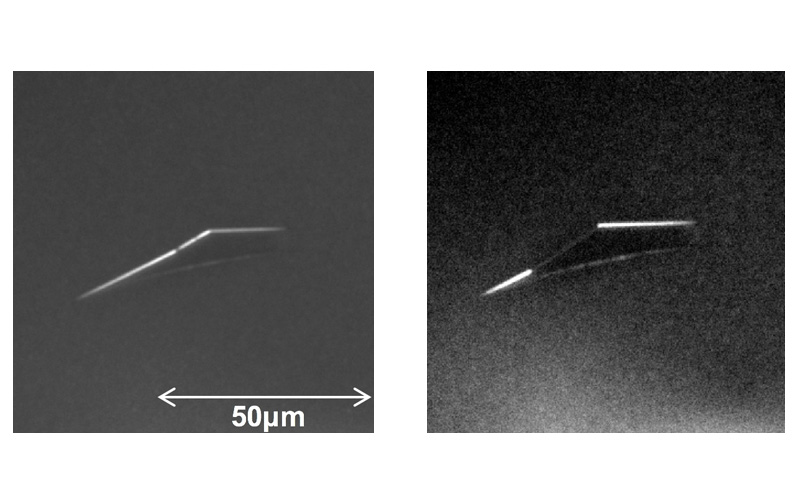
◆高分辨率光致发光图像
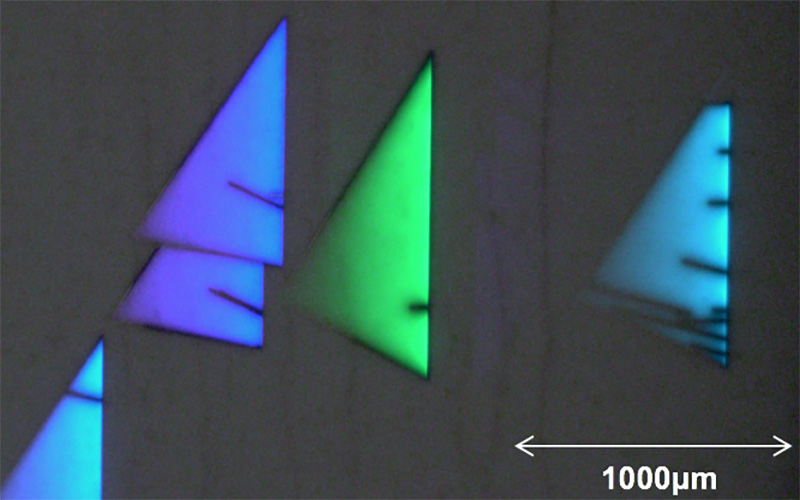
◆彩色光致发光图像

◆晶圆全面测量
外围设备
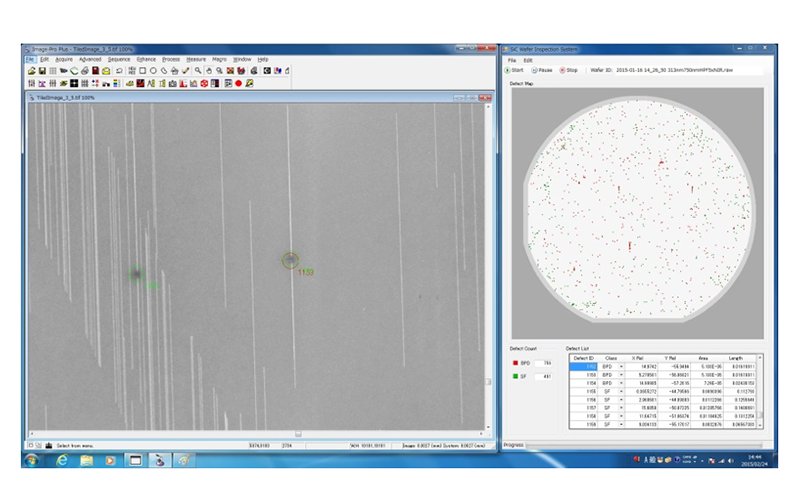
| 晶体缺陷分析装置
◆通过基于所获取的光致发光图像执行图像分析来自动检测晶体缺陷的设备
◆列出并显示晶体缺陷的类型和坐标
◆点击清单,能读取所选晶体缺陷的测量图像
◆可以同时进行测量和图像分析,并可在测量结束后立即确认自动检测结果

| 运输机器人
◆为宽带隙半导体透明晶圆开发的传输机器人
◆可以兼容φ150mm晶圆和φ100mm晶圆而无需更换机器臂
◆配备2个机器臂,实现晶圆传送时间的缩短
| 内置光致发光成像系统
◆提供内置式设备,可以与晶体生长设备等进行组合。
◆能够对晶体生长过程中的原位进行光致发光测量
◆根据研究需要,提供定制




